Įvaldyti litavimo rutulinių tinklelio masyvų meną
Efektyvios ir patikimos puslaidininkių pakuotės padėties negalima pervertinti greitai besivystančiame elektroninių prietaisų gamybos pasaulyje.„Ball Grid“ masyvo (BGA) technologija atsiranda kaip idealus sprendimas patenkinti augančius šiuolaikinės elektronikos poreikius aukštesniam našumui ir miniatiūrizavimui.Šis straipsnis įsigilina į sudėtingą BGA technologijos detales, ištirti jos galutinius komponentus, procesus ir techninius iššūkius, kuriuos ji sprendžia puslaidininkių pakuotėje.Nuo pagrindinės BGA struktūros ir pranašumų, palyginti su tradicinėmis PIN kodomis, tokiomis kaip „Quad Flat Pack“, iki modernių litavimo, tikrinimo ir pakartotinio darbo procesų, diskursas siūlo išsamią analizę.Katalogas

1 paveikslas: „Ball Grid“ masyvas
Ball tinklelio masyvų pagrindai
„Ball Grid“ masyvas (BGA) yra modernus puslaidininkių pakuotės sprendimas, skirtas įveikti senesnių, kaiščių pagrįstų metodų, tokių kaip „Quad Flat Pack“, iššūkius.Užuot naudoję trapius kaiščius, BGA remiasi daugybe mažų litavimo rutulių.Šie rutuliai yra tiksliai išdėstyti ant pakuotės apačios ir yra skirti sujungti su vario trinkelėmis ant spausdintos plokštės (PCB).Kai šildant, litavimo rutuliai ištirpsta ir pritvirtina BGA prie lentos, sukurdami tvirtą ir patikimą ryšį.
BGA formatas suteikia keletą praktinių pranašumų.Pirma, tai supaprastina PCB išdėstymą, nes sumažina tankiai supakuotų sujungimų, kurių reikia ankstesnėms pakavimo sistemoms, poreikį.Šis efektyvesnis išdėstymas daro BGA patvaresnį ir sumažina žalos riziką tvarkymo metu, skirtingai nei subtilūs kaiščiai, rasti senesniuose pakuotėse, kurie gali lengvai sulenkti ar lengvai sulaužyti.
Be to, BGA siūlo puikų šilumos valdymo ir elektros efektyvumo efektyvumą.Trumpas, tiesioginis BGA ir PCB ryšys padeda efektyviau išsklaidyti šilumą, o tai padeda išlaikyti grandinių stabilumą esant šiluminiam stresui.Taip pat trumpesni elektriniai keliai, esantys BGA, sumažina signalo praradimą, o tai ypač svarbūs įrenginiams, veikiantiems aukštais dažniais.Šis ilgaamžiškumo, šilumos išsisklaidymo ir elektrinio efektyvumo derinys daro BGA pakuotę vis populiaresniu pasirinkimu šiuolaikiniams elektroniniams prietaisams, nes jų sudėtingumas ir našumo poreikiai auga.
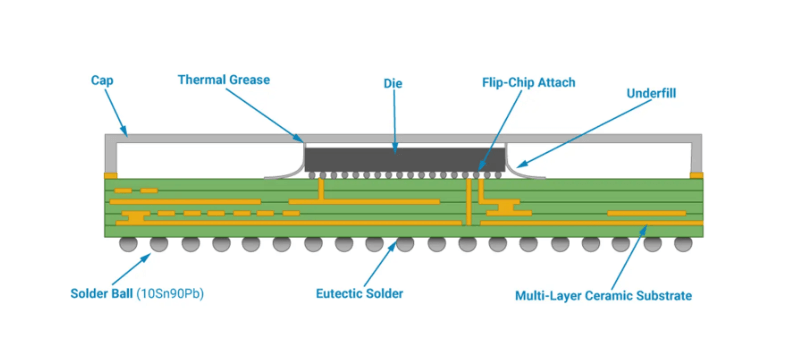
2 paveikslas: BGA litavimo procesas
Naršyti BGA litavimo procesą
Iš pradžių buvo suabejotas rutulinio tinklo masyvo litavimo procesas (BGA) dėl susirūpinimo dėl jo patikimumo ir sunkumų apžiūrėti jungtis, paslėptas po komponentu.Nepaisant to, laikui bėgant „BGA“ litavimas pasirodė esąs patikimesnis nei senesnės sistemos, pavyzdžiui, „Quad Flat“ pakuotės, dėl tikslios kontrolės litavimo proceso metu.Dėl to pagerėjusio patikimumo jis buvo plačiai naudojamas tiek didelio masto gamyboje, tiek mažesniuose, prototipuose PCB rinkiniuose.
Reflovo litavimo metodas dominuoja pritvirtinant BGA prie spausdintos plokštės (PCB).Šiame procese visas mazgas kaitinamas iki tam tikros temperatūros, kur litavėjas, esantis po BGA, ištirpsta į pusiau skysčio būseną.Šis etapas yra kruopščiai valdomas, kad būtų užtikrinta, jog lydmetalis palaiko savo struktūrą ir nesukelia litavimo rutulių griūties ar sujungimo.Tikslus temperatūros reguliavimas yra rimtas, nes visi svyravimai gali paveikti jungčių kokybę.
Išsamiai refložo proceso bruožas yra tai, kaip išlydytas lydmetalis elgiasi.Natūralus jo paviršiaus įtempimas padeda BGA patraukti tobulą suderinimą su PCB trinkelėmis, net jei komponentas buvo šiek tiek ne centre.Šis savaiminio taisymo gebėjimas užtikrina, kad kiekvienas ryšys būtų tinkamai sukurtas be rankų pakeitimų.Dėl šių pažengusių metodų BGA litavimas ne tik daro labai patikimą, bet ir efektyvesnius, padedančius BGA padaryti pageidaujamą pasirinkimą šiuolaikinėje grandinės lentos gamyboje.
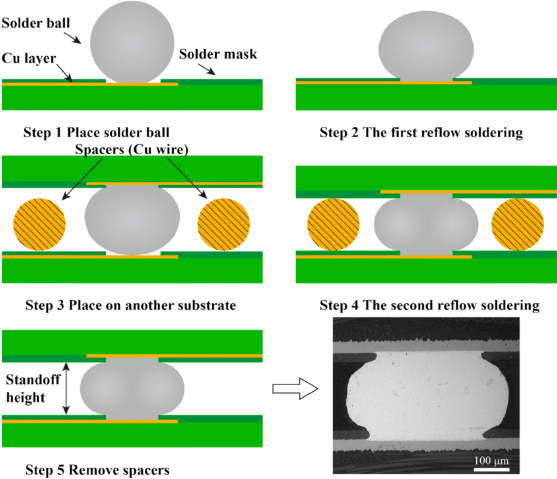
3 paveikslas: BGA litavimo jungties patikrinimas
Kaip efektyviai apžiūrėti BGA litavimo jungtis?
BGA lydmetalio jungčių tikrinimas yra atkakli surinkimo proceso dalis, apsunkinanti tai, kad sąnariai yra paslėpti po BGA komponentu.Kadangi tradicinis vaizdinis patikrinimas negali pasiekti šių paslėptų jungčių, norint gauti aiškų, neinvazinį litavimo jungčių vaizdą naudojami rentgeno ir automatizuotos rentgeno tikrinimo (ASI) metodai.
Rentgeno tikrinimas yra naudingas norint kruopščiai patikrinti kiekvieną litavimo jungtį.Vaizdo gavimas leidžia technikams užtikrinti, kad visi litavimo rutuliai būtų tinkamai ištirpę ir sudarė stiprius ryšius su PCB.Šis žingsnis naudojamas nustatant tokias problemas kaip šaltos sąnariai, kai litavėjas nevisiškai ištirpo arba tuštumos, kurios yra oro kišenės, kurios laikui bėgant gali susilpninti sąnarį.
Naudodamiesi rentgeno technologija, inspektoriai gali patvirtinti, kad reflovacijos proceso metu buvo naudojamas tinkamas šilumos kiekis ir kad litavimo jungtys atitinka tikslius standartus.Šis tikrinimo lygis užtikrina, kad galutinis produktas yra patikimas ir gali atlaikyti veiklos stresą, su kuriuo gali susidurti, ir padeda išlaikyti aukštą gamybos kokybę.
Veiksmingos BGA pertvarkymo elektronikoje strategijos
BGA komponento pertvarkymas yra labai tiksli užduotis, kuriai reikia atidžiai valdyti šildymo procesą.Šis darbas paprastai atliekamas specializuotoje pertvarkymo stotyje su įrankiais, sukurtais specialiai darbui.Lokalizuotas infraraudonųjų spindulių šildymas naudojamas nukreipti BGA neperkaitinant netoliese esančių dalių.Kai litavėjas po komponentu tirpsta, vakuuminis įrankis atsargiai pakelia BGA nuo lentos.Viso šio proceso metu šiluma turi būti tiksliai kontroliuojama, kad būtų išvengta sugadinusių gretimų komponentų, pabrėžiant poreikį išplėstinei pertvarkymo įrangai.
Sėkmingas BGA pertvarkymas priklauso nuo tikslios temperatūros nustatymų palaikymo ir aplinkos valdymo aplink komponentą.Tai neleidžia aplinkinėms grandinėms paveikti pašalinimo ir pakeitimo sugedusio BGA metu.Užduotis reikalauja giliai suprasti, kaip veikia BGA ir kvalifikuotas tvarkymas, kad procesas būtų atliktas teisingai.Dėl šių sudėtingumų BGA pertvarkymas yra subtili operacija, reikalaujanti ir tinkamos įrangos, ir patyrusiems technikams, kad būtų išlaikytas visos surinkimo vientisumas.

4 paveikslas: BGA PCB žemės modeliai
BGA PCB žemės modelių projektavimo strategijos
Projektuoti BGA PCB žemės modelius reikia tiksliai atkreipti dėmesį į detales, kad būtų užtikrintas sklandus ir saugus ryšys surinkimo metu.Žemės modeliai turi būti tobulai suderinti su BGA tinkleliu, užtikrinant, kad kiekvienas litavimo rutulys tiksliai atitiktų atitinkamą padėklą.Pagrindinės dizaino savybės, tokios kaip litavimo kaukės reljefas, o kai kuriais atvejais paliekant kaukės padėklus, naudojamos tam, kad daugiau litavimo galėtų tekėti ir sukurti stipresnį ryšį.Griežtas IPC standartų laikymasis yra naudingas norint pasiekti sėkmingo BGA litavimo tikslumo lygį.
Kiekvienas žemės modelio aspektas turi būti atidžiai suplanuotas, kad būtų patenkinti konkretūs BGA komponento reikalavimai.Tai apima trinkelių dydžio pritaikymą ir kruopščiai valdant padėties nuokrypius, kad įsitikintumėte, jog kiekvienas ryšys yra nepriekaištingas.Galvojamasis planavimas projektavimo etape užtikrina, kad litavimo procesas yra efektyvus ir patikimas, ir padeda BGA saugiai pritvirtinti ir tinkamai funkcionuoti PCB mazge.
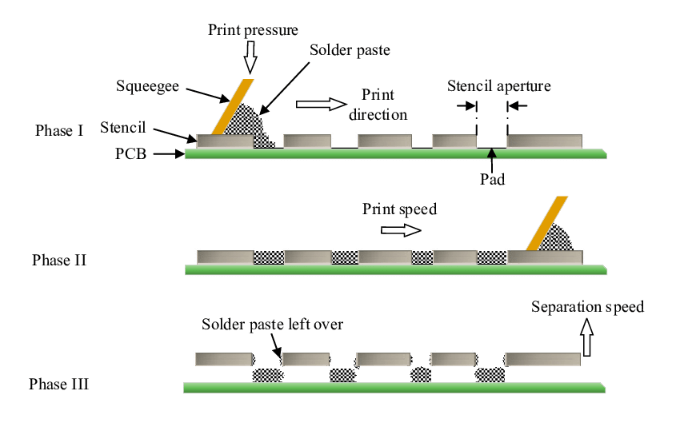
5 paveikslas: BGA litavimo pastos spausdinimas
Tiksliai pasiekus BGA litavimo pastos spausdinimą
Taikant litavimo pastą BGA surinkimui, reikia tikslių trafaretinių metodų, kad būtų užtikrinta, jog po kiekvienu BGA rutuliu deponuojami maži, tikslūs pastos kiekiai.Šiame procese naudojami lazeriai supjaustyti trafaretai, puikiai suderinti su PCB žemės modeliais.Siekiant dar labiau pagerinti tikslumą ir sumažinti tokius defektus kaip litavimo elementas, šie trafaretai dažnai gydomi nanokateriais.Tada miniatiūrinės spausdinimo galvutės atsargiai kontroliuoja pastos kiekį, pritaikytą ant kiekvienos padėklo, o optinio patikrinimo sistemos tikrina, kad pastas dedamas tiksliai.
Naudojamos litavimo pastos tipas - 3 tipo arba 4 tipas - priklauso nuo konkretaus mazgo klampumo.Pastos pasirinkimas tiesiogiai daro įtaką tai, kaip gerai lydmetalio jungtys formuojasi reflavimo proceso metu.Kadangi šiame etape yra pagrindinė galutinių jungčių stiprumo ir patikimumo pagrindus, litavimo pastos spausdinimo procesas yra pavojinga BGA surinkimo dalis, reikalaujanti kruopštaus dėmesio detalėms, kad būtų užtikrinta aukštos kokybės rezultatai.
BGA litavimo sudėtingumas
BGA litavimas sukelia unikalių sunkumų, nes litavimo jungtys yra paslėptos po komponentu, todėl tiesioginis vaizdinis patikrinimas yra neįmanomas.Norint tai išspręsti, jungčių apžiūrėti naudojamos specializuotos priemonės, tokios kaip rentgeno mašinos, o infraraudonųjų spindulių pakartotinių dirbinių stotys leidžia tiksliai suderinti komponentą, kai to reikia.Litavimo proceso tvarkymas taip pat reikalauja atidžiai kontroliuoti šilumą, kad būtų išvengta litavimo jungčių, o tai gali sukelti įtrūkimus.Panašiai visi litavimo rutuliai turi išlaikyti tą patį aukštį (koplanariškumą), kad būtų užtikrintas nuoseklus našumas ir ilgalaikis patikimumas.
Aplinkos veiksniai, tokie kaip senėjimas ir jautrumas drėgmei, dar labiau apsunkina procesą.Šios problemos turi būti griežtai kontroliuojamos, kad laikui bėgant būtų išvengta lydmetalio sąnarių pablogėjimo.Sėkmingai naršyti šiuos iššūkius reikia gerai suprasti BGA litavimo metodus ir pažangios įrangos naudojimą.
Įvairių tipų rutulinių tinklelių masyvų
„Ball Grid“ masyvo (BGA) technologija yra integruotų grandinių (ICS) montavimo metodas ant spausdintų grandinių plokščių (PCB), gerinančių elektrinį ryšį ir šilumos išsklaidymą.Norėdami sukurti saugias jungtis, jis naudoja daugybę litavimo rutulių, esančių po komponentu.

6 paveikslas: plastikinių rutulinių tinklelių matricos (PBGA)
Plastikinės BGA yra plačiai naudojamos, nes yra prieinamos ir užtikrina patikimą našumą daugumai standartinių programų.Jie susideda iš plastikinio substrato su litavimo rutuliais, pritvirtintais apačioje.Tai dažnai randama vartojimo elektronikoje, automobilių sistemose ir kituose įrenginiuose, kurie neveikia ekstremaliomis sąlygomis.Jų paprastas dizainas siūlo gerą elektros sujungimą ir vidutinio sunkumo šilumos valdymą, kurio pakanka kasdieniam naudojimui.
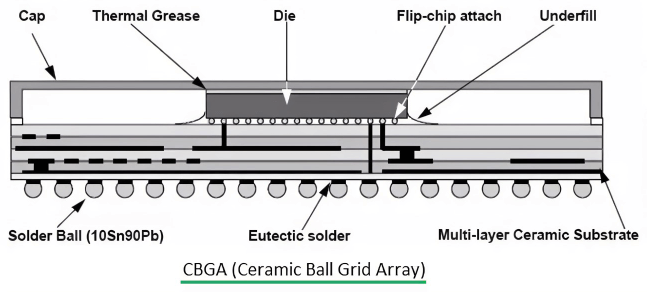
7 paveikslas: Keraminių rutulinių tinklelių matricos (CBGA)
Keraminiai BGA naudoja keraminį substratą, todėl jie yra atsparesni šilumos ir elektriniams trukdžiams nei plastikinės BGA.Šis patvarumas daro juos idealiais tokioms aplinkoms kaip telekomunikacijos, kosmoso ir aukščiausios klasės serveriai.Keramika suteikia puikią izoliaciją ir gali valdyti tiek aukštą temperatūrą, tiek mechaninį įtempį, užtikrinant ilgalaikį prietaiso patikimumą.
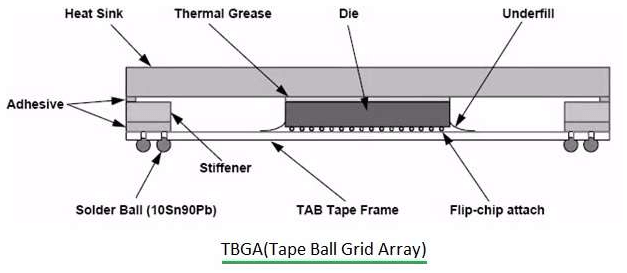
8 paveikslas: BGAS juosta (TBGA)
Juostos BGA yra suprojektuotos su lanksčiu substratu, kuris gali atitikti PCB paviršių, pagerinant tiek mechaninį ryšį, tiek šilumos išsklaidymą.Šie BGA yra idealūs nešiojamoms elektronikoms ir didelio tankio įrenginiams, kur erdvė yra ribota.Lankstus substrato pobūdis leidžia geresnį šiluminį valdymą kompaktiškose vietose, todėl jie yra tinkamiausias pasirinkimas išmaniesiems telefonams ir kitiems nešiojamiesiems įrenginiams.
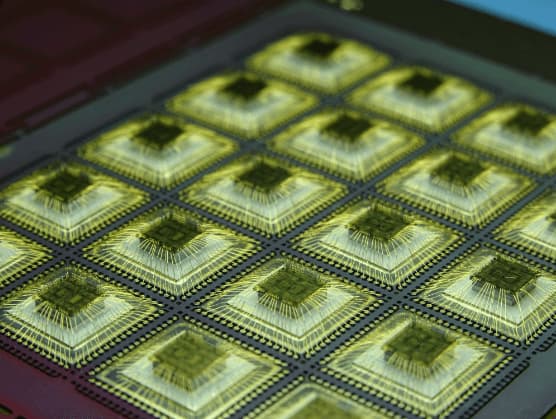
9 pav.
Įrenginiuose naudojami sukrauti BGA, kuriems reikia daug perdirbimo galios supakuoti į mažą erdvę.Šis tipas sukrauna kelias integruotas grandines vertikaliai į vieną paketą, leidžiančią atlikti daugiau funkcijų, nepadidindama įrenginio dydžio.Sukraustos štampo BGA dažniausiai randamos išmaniuosiuose telefonuose, planšetiniuose kompiuteriuose ir kitoje kompaktiškoje elektronikoje, kuriai reikalingas didelis našumas mažos formos faktoriuje.
Išvada
„Ball Grid Array“ (BGA) technologijos tyrinėjimas pabrėžia pagrindinį vaidmenį šiuolaikinėje elektronikos gamybos peizaže.Kaip išsamiai aprašyta šiame straipsnyje, BGA pakuotėje ne tik nagrinėjami senesnių pakavimo metodų fiziniai apribojimai, bet ir žymiai pagerina našumą geresniu šilumos valdymu ir elektros efektyvumu.Techniniai procesai, susiję su BGA litavimu, tikrinimu ir pertvarkymu, atspindi tikslumą ir patikimumą, užtikrinant, kad elektroniniai prietaisai atitiktų griežtus šių dienų technologinių standartų reikalavimus.
Be to, įvairių tipų BGA, pradedant plastikinėmis BGA ir baigiant dideliu šilumos laidumo metalo viršutine BGA, pritaikant plataus spektrą, įrodant BGA technologijos universalumą ir pritaikomumą.Galų gale, nuolat tobulėjant elektroniniams prietaisams, BGA technologija išliks būtina, ir toliau skatins naujoves ir išlaikys aukštus puslaidininkių pakuočių kokybės standartus.
Dažnai užduodami klausimai [DUK]
1. Kaip lituoti BGA paketą?
Pasiruošimas: Pradėkite valydami BGA paketą ir PCB (spausdintos plokštės), kad būtų pašalinti visi teršalai ar likučiai.
Suderinimas: Atsargiai suderinkite BGA paketą PCB, užtikrindami, kad visos lusto trinkelės suderintų su atitinkamomis lentos trinkelėmis.
Litavimas: Naudokite reflavimo litavimo procesą.Įdėkite PCB su BGA į „Roflow“ krosnį.Šildymo ciklo metu jau naudojamas litavėjas, jau pritvirtintas prie pagalvių ir suformuos jungtis.
Aušinimas: Leiskite PCB lėtai atvėsti po reflovos proceso, kad būtų išvengta bet kokio šiluminio įtempio.
2. Kas yra BGA litavimo metu?
BGA reiškia „Ball Grid“ masyvo.Tai yra tam tikros rūšies ant paviršiaus montuojama pakuotė, naudojama integruotoms grandinėms.„BGA“ pakuotėse naudojami mažyčiai litavimo rutuliai, pritvirtinti prie pakuotės apatinės dalies, kad būtų sukurtos elektrinės jungtys su PCB, o ne tradiciniais laidais.
3. Kaip atlikti rutulio litavimą?
Rutulio išdėstymas: Užtepkite litavimo pastą ant PCB trinkelių, kur bus dedama BGA.Padėkite BGA taip, kad kiekvienas litavimo rutulys atitiktų atitinkamą PCB padėklą.
RUGLINIS LITOLIS: Įkaitinkite mazgą „Rovelw Orven“.Lydmetalio pasta ištirps, sujungdama litavimo rutulius prie trinkelių ir sukurdama tvirtą elektrinį ir mechaninį ryšį.
Patikrinimas: Po litavimo apžiūrėkite jungtis, ar nėra tiltų ar blogų jungčių, paprastai naudodamiesi rentgeno spinduliais, kad pamatytumėte po BGA.
4. Kaip patikrinti BGA litavimą?
Vaizdinis patikrinimas: Iš pradžių patikrinkite, ar nėra matomo poslinkio ar defektų aplink BGA paketą.
Rentgeno tikrinimas: Kadangi BGA litavimo negalima visiškai patikrinti vizualiai dėl paslėpto jungčių pobūdžio, naudokite rentgeno apžiūrą, kad ištirtumėte litavimo jungtis po BGA.
Funkcinis testavimas: Galiausiai atlikite elektrinius bandymus, kad įsitikintumėte, jog visos jungtys veikia teisingai.
5. Kokia temperatūra turėtų būti „BGA“ litavimas?
Tipiška temperatūra: Tiksli litavimo BGA temperatūra priklauso nuo naudojamos litavimo pastos.Paprastai litavimo pastos be švino reikalauja temperatūros, esančios maždaug 217 ° C iki 245 ° C.Patikrinkite, ar litavimo pastos gamintojo specifikacijose nėra tikslios temperatūros.
Reflovo profilis: Laikykitės konkretaus šiluminio profilio, kuris palaipsniui šildo mazgą iki reikiamos pakartotinio temperatūros, sulaiko jį pakankamai ilgai, kad užtikrintų tinkamą lydmetalio tirpimą, ir tada palaipsniui vėsina, kad išvengtų šiluminio įtempio.